
図1.Pイオン注入ZnSeの光導電スペクトル
(From S. Adachi & Y. Machi, Jpn. J. Appl. Phys. 15, p.1513, 1976)
A II-VI族化合物半導体へのイオン注入技術
今から約25年位前に修士課程で行った研究(指導教官:町好雄教授、中野道夫元学長)であり、緑や青色発光デバイス開発のための基礎技術としてとらえ、研究を進めた(日立中研、東芝総研等のご協力)。ZnSeのp型導電型変換を目指し、PやNイオン等の注入を試みた。図1に示すごとく、シャローなp型アプセプタを光導電実験で見つけ、修士課程研究にしては脚光を浴びた。研究では、n型ドーパントのイオン注入も試みている。この時期、イオン注入に関する理論を勉強するため、あの偉大なN. Bohr博士の論文を読んで四苦八苦したことを、鮮明に思い出す。

図1.Pイオン注入ZnSeの光導電スペクトル
(From S. Adachi & Y. Machi, Jpn. J. Appl. Phys. 15, p.1513, 1976)
B 半導体の化学エッチング技術
NTT電気通信研究所での初期の研究テーマである.InGaAsP/InPやGaAs系の化学エッチングを系統的に調べ、論文を主に米国電気化学会誌に発表した。これら研究成果は、国内・外の研究者に今でも重宝がられている.一例として、論文査読者から"地球を揺るがすほどではないが、すばらしい"とお誉めを頂いた論文からの図面を、図2に示す.
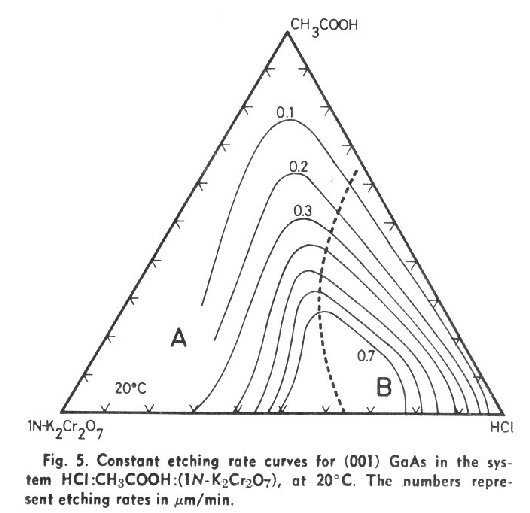
図2.GaAsのエッチング速度コントーア曲線
(From S. Adachi & K. Oe, J. Electrochem. Soc. 131, p.126, 1984)
C III-V族化合物半導体へのイオン注入技術
イオン注入技術は、今日ではほぼ確立した技術と見なされがちであるが、特定の材料については未だ重要な研究対象(特に企業研究所)といえる。III-V族結晶ではAlGaAsがそれにあたり、私がこの研究の着手当時は、低い活性化率とアニールによるドーパント不純物の異常拡散は、全くのお手上げ状態であった。これを、フッ素(F)を補助イオンとする二重イオン注入で克服することができた。フッ素導入の経緯は気まぐれであり、日頃よく努力する人に勝利の女神が微笑むといったところか。フッ素との二重イオン注入による素晴らしいデータの一例を、図3に示す。
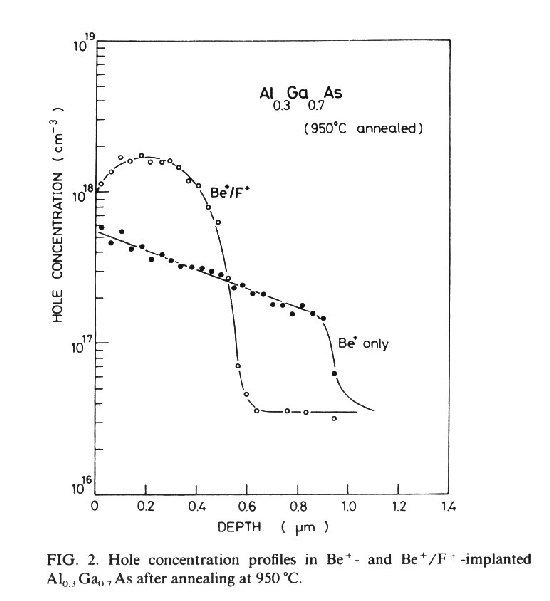
図3.F/Be二重イオン注入によるホール濃度の深さ方向分布
(From S. Adachi, Appl. Phys. Lett. 51, p.1161, 1987)
D 高融点金属Wのスパッタ堆積、エッチング技術
高融点金属W (タングステン) のスパッタ堆積、エッチング技術を確立した。特記すべきは、CF4やSF6などのポピュラーなエッチングガスに窒素ガスを混合させることで、フォトレジストとのエッチレート選択比が飛躍的に向上し、エッチ速度も急増することを発見したことである。当時、ドライエッチに窒素ガスを混合させようと考えた研究者は皆無だった。二匹目のドジョウ(女神)がここにもいたと言うところか。図4は、窒素ガス混合によるWとフォトレジストとのエッチ速度を比較した図である。
以上
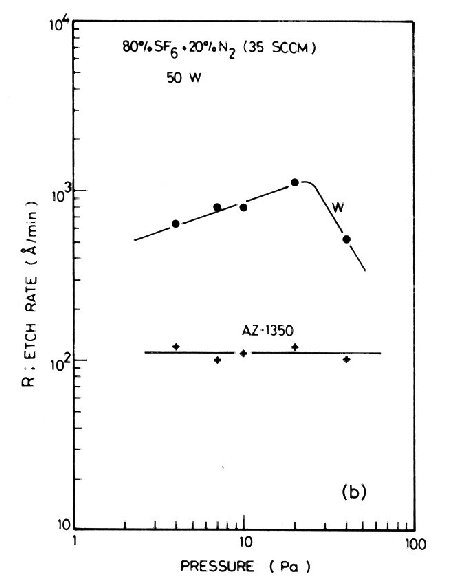
図4.SF6/N2ガスによるWとフォトレジスト(AZ-1350)とのエッチ速度比較
(From S. Adachi & N. Susa, J. Electrochem. Soc. 132, p.2980, 1985)